用于廣泛電源管理的 BiGaN 開關(guān)
出處:網(wǎng)絡(luò)整理 發(fā)布于:2024-10-21 16:14:59
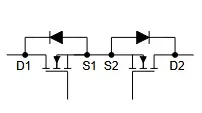
由于其垂直結(jié)構(gòu),MOSFET 具有很大的集成困難。在單個(gè)芯片上集成兩個(gè) FET 非常具有挑戰(zhàn)性,其成本、RDS(on) 和電壓值對(duì)于大約 30 V 及以上的器件而言是的。相比之下,由于 GaN 高電子遷移率場(chǎng)效應(yīng)晶體管 (HEMT) 的側(cè)面結(jié)構(gòu)并且沒有寄生二極管,因此制造單片雙向 GaN 開關(guān)非常簡(jiǎn)單。
更低的泄漏和空間要求
在智能手機(jī)電池管理系統(tǒng)中使用過壓保護(hù) (OVP) 開關(guān)旨在限制總損耗,同時(shí)保持盡可能小的占地面積。在這個(gè)特定應(yīng)用中,斷路器阻斷傳導(dǎo)電壓或電流,而不需要在兩種狀態(tài)之間頻繁切換。因此,柵極充電不會(huì)造成明顯的開關(guān)損耗。總損耗基本上僅由傳導(dǎo)損耗以及器件的總導(dǎo)通電阻決定。
傳統(tǒng)上,OVP 功能是通過背對(duì)背連接的分立 MOSFET 來實(shí)現(xiàn)的。新的 BiGaN 器件技術(shù)的尺寸比普通的單 GaN HEMT 稍大。與在雙向開關(guān)配置中采用兩個(gè)分立器件相比,該設(shè)計(jì)的導(dǎo)通電阻要低得多,并且提供了更緊湊的解決方案。
在傳統(tǒng) MOSFET 中,RDS (導(dǎo)通)是器件完全導(dǎo)通時(shí)漏極和源極之間的電阻。 BiGaN器件的對(duì)應(yīng)值為RDD(on),即器件完全導(dǎo)通時(shí)兩個(gè)漏極之間的電阻。該封裝可以對(duì)導(dǎo)通電阻做出重大貢獻(xiàn)。 BiGaN 器件的橫向結(jié)構(gòu)提供的寄生電阻,有助于減少傳導(dǎo)損耗和熱耗散。其緊湊性還保證了出色的“導(dǎo)通電阻*面積”(Ron*A) 性能,這是系統(tǒng)小型化的一個(gè)重要因素。,單個(gè) BiGaN 器件取代了兩個(gè) MOSFET,從而顯著減少了占地面積并簡(jiǎn)化了材料清單。
評(píng)估 BiGaN 器件的個(gè)選擇是保留現(xiàn)有的面積和占用空間,這大大降低了導(dǎo)通電阻值,從而限制了充電時(shí)的溫升。另一方面,BiGaN 顯著減少了 OVP 功能的占地面積,同時(shí)保持良好的導(dǎo)通電阻,從而保持良好的效率。圖 2 突出顯示了通過使用 BiGaN 器件調(diào)節(jié)智能手機(jī)電池電量所獲得的結(jié)果。

SOA 和分散
安全操作區(qū) (SOA) 是負(fù)載開關(guān)應(yīng)用中的一個(gè)重要元素。此參數(shù)指定允許設(shè)備正常運(yùn)行而不會(huì)損壞或性能下降的電壓和電流組合。限制 SOA 的因素包括 R值以及某些封裝和散熱方面。由于閾值電壓 (Vth) 的負(fù)溫度系數(shù),提高硅 MOSFET 的 SOA 很復(fù)雜。由于 GaN 器件中的 VTH 值隨溫度變化較小,因此 BiGaN 技術(shù)即使在高溫下也能保持更好的 SOA 性能。
使用雙向電壓阻斷的應(yīng)用中的另一個(gè)重要因素是柵極泄漏。 Si MOSFET 具有出色的柵極漏電性能。在這些器件中,柵極通過柵極電介質(zhì)(氧化物)與溝道絕緣,從而在 25 °C 時(shí)漏電流小于 μA。當(dāng)溫度升高時(shí),Si MOSFET 的 Vth 值會(huì)下降,而漏電流會(huì)增加。
BiGaN 器件具有獨(dú)特的柵極結(jié)構(gòu),可以將其描述為兩個(gè)背對(duì)背連接的二極管。如果沒有適當(dāng)?shù)目刂疲珺iGaN 器件的柵極泄漏會(huì)比 Si MOSFET 更多。這種需求對(duì)于在智能手機(jī)中實(shí)施該解決方案至關(guān)重要。
BiGaN 器件的控制
與 Si 背靠背 MOSFET 一起使用的電流驅(qū)動(dòng)器也可以與 BiGaN 技術(shù)一起使用,前提是驅(qū)動(dòng)電壓為 5 V。就智能手機(jī)而言,大多數(shù)充電器 IC 與具有 5 V 柵極驅(qū)動(dòng)器的 HEMT GaN 晶體管兼容。
柵極電壓必須至少高于 Drain1 或 Drain2 的 V th (~1.7 V) 才能開啟 BiGaN 器件。要關(guān)閉它并阻止任一方向的電流流動(dòng),從柵極到漏極的電壓(VGD1和V GD2)必須小于 V th或柵極接地(地)。 BiGan 在 5 V 應(yīng)用中可由電荷泵驅(qū)動(dòng)(圖 3)。當(dāng) EN 為低電平時(shí),柵極電壓為零,BiGaN 將關(guān)閉。當(dāng) EN 為高電平時(shí),柵極電壓將被泵壓至 V IN + 5V,BiGaN 將導(dǎo)通,V OUT將等于 V IN。
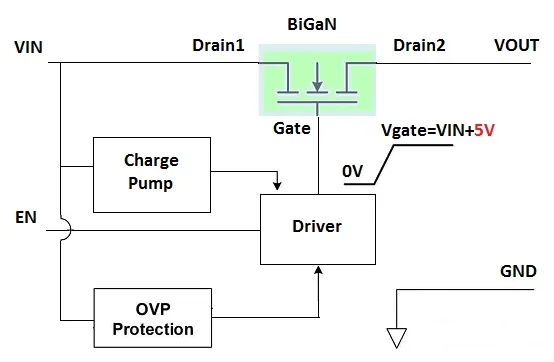
具有 5 V 柵極驅(qū)動(dòng)器的 IC 通常僅限于在智能手機(jī)應(yīng)用中使用。此類應(yīng)用使用電壓約為 10 V 的驅(qū)動(dòng)器,旨在從 Si MOSFET 獲得盡可能的 RDS (導(dǎo)通)值。這些驅(qū)動(dòng)器的驅(qū)動(dòng)電壓高于柵極額定值,因此不能直接驅(qū)動(dòng) GaN HEMT。在這些應(yīng)用中,可以使用帶有齊納二極管(D1 和 D2)的終端電路在電壓低于 6V 時(shí)連接 V GD (圖 4)。為了實(shí)現(xiàn)漏極到柵極阻斷,二極管 D4 和 D5 的擊穿電壓大于 40 V。
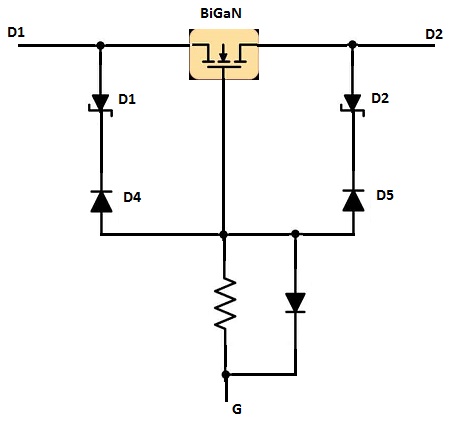
版權(quán)與免責(zé)聲明
凡本網(wǎng)注明“出處:維庫(kù)電子市場(chǎng)網(wǎng)”的所有作品,版權(quán)均屬于維庫(kù)電子市場(chǎng)網(wǎng),轉(zhuǎn)載請(qǐng)必須注明維庫(kù)電子市場(chǎng)網(wǎng),http://hbjingang.com,違反者本網(wǎng)將追究相關(guān)法律責(zé)任。
本網(wǎng)轉(zhuǎn)載并注明自其它出處的作品,目的在于傳遞更多信息,并不代表本網(wǎng)贊同其觀點(diǎn)或證實(shí)其內(nèi)容的真實(shí)性,不承擔(dān)此類作品侵權(quán)行為的直接責(zé)任及連帶責(zé)任。其他媒體、網(wǎng)站或個(gè)人從本網(wǎng)轉(zhuǎn)載時(shí),必須保留本網(wǎng)注明的作品出處,并自負(fù)版權(quán)等法律責(zé)任。
如涉及作品內(nèi)容、版權(quán)等問題,請(qǐng)?jiān)谧髌钒l(fā)表之日起一周內(nèi)與本網(wǎng)聯(lián)系,否則視為放棄相關(guān)權(quán)利。
- 電源管理IC在物聯(lián)網(wǎng)設(shè)備中的應(yīng)用2026/4/17 11:09:03
- 電源管理IC在智能家居中的應(yīng)用2026/4/14 15:51:13
- 高溫環(huán)境下電源IC選型建議2026/4/13 13:53:19
- 電源IC在惡劣環(huán)境中的防護(hù)設(shè)計(jì)2026/4/10 11:03:45
- 電源IC在便攜式設(shè)備中的設(shè)計(jì)要點(diǎn)2026/4/9 10:06:18
- 高速PCB阻抗控制核心實(shí)操規(guī)范
- 高速數(shù)字系統(tǒng)(如DDR、SerDes)中的信號(hào)完整性濾波
- MOSFET在UPS電源中的應(yīng)用解析
- 電源管理IC在物聯(lián)網(wǎng)設(shè)備中的應(yīng)用
- SMT連接器焊接缺陷分析
- MOSFET在汽車電子中的應(yīng)用要求
- 通信設(shè)備電源管理IC應(yīng)用解析
- 通信設(shè)備連接器選型與設(shè)計(jì)
- PCB電磁兼容性(EMC)設(shè)計(jì)核心實(shí)操規(guī)范
- 物聯(lián)網(wǎng)節(jié)點(diǎn)低功耗設(shè)計(jì):信號(hào)鏈中的濾波與功耗管理









